レーザーオプティクスに対する測量
本ページはレーザーオプティクスリソースガイドのセクション15.1, 15.2, 15.3, 15.4, 15.5, 15.6です
測量は、光学部品が要求される仕様に一貫して適合し、安全に機能することを確実にするうえで極めて重要になります。この信頼性は、ハイパワーレーザーを利用するシステム、もしくはスループットの変化がシステム性能に支障をもたらす場合にとりわけ重要です。レーザーオプティクスの測定には、キャビティリングダウン分光法、原子間力顕微鏡法、微分干渉コントラスト顕微鏡法、光学干渉法、シャックハルトマン波面センサー、分光光度計を始め、広範な測量法が用いられます。
キャビティリングダウン分光法
キャビティリングダウン分光法 (Cavity Ring Down Spectroscopy; CRDS) は、気体サンプルの組成を判断するために用いられる測量法ですが、レーザーオプティクスでは光学用コーティングによる損失を高感度に測定するのに用いられます。CRDS システムでは、2枚の高反射ミラーで構成された共振器キャビティ内にレーザーパルスが送られます。反射する度にごく少量の光が吸収・散乱・透過によって損失し、反射した光は共振器内を往復します。2番目のミラーの背後にある検出器が反射光の強度の減少 (リングダウン) を計測し、この測定値がミラーの損失を計算するのに用いられます (Figure 1)。レーザーミラーの損失の特性化は、レーザーシステムが所望するスループットを実現するかを確実にするためにも欠かせません。

Figure 1: キャビティリングダウン分光計は、共振器キャビティ内の強度減衰率を測定することで、絶対強度値を直接測定する測量法より高精度な測定を可能にする
キャビティ内部のレーザーパルスの強度 (I) は次式で与えられます:
I0 はレーザーパルスの初期強度、τは透過・吸収・散乱によるキャビティミラー損失の合計、tは時間、cは光速、そしてLはキャビティの長さです。
CRDSで得られた値は、キャビティ全体の損失です。したがって、1枚だけのミラーの損失を決定するには、テストを複数回行う必要があります。2枚の参照ミラーが最初の測定を行うのに用いられ (A)、次に2回の更なる測定が行われます: 1回目は最初の参照ミラーを被験ミラーに置き換えた場合 (B)、2回目は他方の参照ミラーを被験ミラーに置き換えた場合 (C) です。この3回の測定が被験ミラーの損失を決定づけるのに行われます。
M1 と M2 2枚の参照ミラー各々の損失、M3 は被検ミラーの損失です。ここでは、キャビティ内の空気中の損失は無視できると仮定します。CRDSは、小さな損失の量を正確に計測する方のが大きな反射率を同様に計測するよりも遥かに 容易であることから、反射型レーザーオプティクスの性能の特性化に最適な方法となります (Table 1)。反射防止コーティングが施された透過型部品も、共振器キャビティ内に挿入して、それによる損失の増加量を計測することで試験できます。CRDSでは、ミラー上やキャビティ内部のいかなるコンタミも損失の測定に影響を及ぼすため、クリーンな環境で細心の注意を払って実施されなければなりません。

Table 1: ±0.1%の不確実性でミラーの反射率を直接測定する時の感度の方が、±10%の不確実性でミラーの損失を測定するよりも2桁感度が上がってしまう。これは、高反射率ミラーには、損失測定の方が反射率測定よりも遥かに正確であることを表している
CRDSの詳細と高反射率レーザーミラーを測定する際のメリットについては、以下の録画ウェビナー (英語音声) をご視聴ください。
光学干渉法
光学干渉法は、干渉を利用して小さな変位や面の不規則性、及び屈折率変化を測定します。<λ/20の面イレギュラリティを測定することができ、平面や球面レンズ、非球面レンズ、及びその他光学部品を定量化するのに用いられます。
干渉は、光の複数の波が重なり合い、新たなパターンが形成された時に起こります。干渉が起こるためには、複数の光の波の位相が揃い、かつ偏光状態が互いに直交していない状態になければなりません1。波の山同士、または谷同士が揃っている場合、増加的干渉を引き起こして振幅が増える方向になります。これに対して、ある波の山と他の波の谷が揃っている場合は、減殺的干渉を引き起こして互いに打ち消しあう方向になります (Figure 2)。

Figure 2: 干渉計は面の形状を決定するのに増加的干渉 (左) と減殺的干渉 (右) を用いる。被検オプティクスと参照オプティクス間の表面形状の違いが位相差を引き起こし、目視可能な干渉縞となって現れる
光学干渉計は、光源からの光をテストビームと参照ビームの2つのビームに分離するのにビームスプリッターを通常使用します。2つのビームは、光検出器に到達する前に再合成されますが、この時2つの光路間の光路長差が干渉を引き起こします。これにより、テストビームの光路中にある光学部品と参照ビームの光路中にある参照板を比較できるようになります (Figure 3)。2つの光路間の増加的干渉と減殺的干渉が、干渉縞のパターンとなって現れます。反射型と透過型の光学部品とも、参照板への透過波面または反射波面と比較することで測定が行えます。

Figure 3: テストビームと参照ビームによって増加的干渉を引き起こす明るいエリアと減殺的干渉を起こす暗いリングを映し出す干渉計のサンプル画像 (左) と、その結果得られた被検オプティクスの3D再構築画像 (右)
光学干渉計には複数の共通する構成があります (Figure 4)。マッハ・ツェンダー干渉計は、1つのビームスプリッターを利用して入射ビームを2つの別々の光路 に分離します。2番目のビームスプリッターで2つの光路を2つの出力に再合成して光検出器に送ります。マイケルソン干渉計 は、ビームの分割と再合成に1枚のビームスプリッターを使用します。マイケルソン干渉計の派生とも言えるトワイマン・グリーン干渉計は、単色点光源を光源に用いて光学部品を測定します。フィゾー干渉計は、マイケルソン干渉計でのビームスプリッターに直交するようにビームスプリッターを追加配置し、システムがミラー一つだけを必要となるようにします。ファブリ・ペロー干渉計は、2枚の平行な部分透過ミラーを用い、2つの別々のビーム光路ではない複数の光路を作り出します。

Figure 4: 代表的な干渉計の構成
干渉計を構成する光学部品上の塵粒子や欠陥は、検査対象の光学部品とは関係なしに光路長差を作り出し、光学部品上の表面欠陥として捉えてしまう可能性があります。光学干渉計は、ビーム光路の正確な制御を必要とし、測定時にレーザー雑音や量子雑音の影響を受けることもあります。
低コヒーレンス長干渉法
低コヒーレンス長や光熱共通光路干渉計などのユニークな干渉計構成には、従来の干渉計とは異なる目的を持つものがあります。低コヒーレンス長干渉計は、照明にレーザーではなく、特殊なLEDを使用します2。このLEDは、一般的なLEDよりも長いコヒーレンス長を持ちますが、レーザーのそれよりは短くなります。これにより、裏面からの反射を最小限に抑えながら、平行でフラッ トな面を測定するシステムを可能にします (Figure 5)。

Figure 5: 特殊なLEDを光源とする低コヒーレンス長干渉計は 裏面側から戻ってくる反射光のノイズを受けずに平行平面を測定できるのに対し (右)、従来のレーザーを用いた干渉計ではノイズの影響を受けてしまう (左)。画像提供: InterOptics LLC2
ウインドウやレーザー結晶、その他の光学部品の平行でフラットな面を従来の干渉計で測定する場合、裏面側にワセリンや他の物質を塗布して光が同面側から反射して戻り、表側側の測定に支障をきたさないようにする必要がありました。こうした物質を塗布するとノイズは少なくなりますが、塗布して測定後にそれを除去し、他方の面も測定するために再び同じ手順を繰り返し、コーティング前にはそれを洗浄しなければならないことから、測定記録にかかる時間が増えてしまいます。ワセリンを取り除くには酢が最も効果的ですが、酸に弱い材料ではヤケになるリスクがあります。またこの方法は、ガラスより遥かに低い、あるいは遥かに高い屈折率を持つ光学部品には効果的ではなく、裏面側がコーティングされている場合は全く効果がありません。
低コヒーレンス長の特殊LEDを使用することは、光学部品の表面側を裏面側から分離することを可能にし、裏面側に特別な処理を施す必要性を排除します。これにより、測定時間を短縮し、部品への損傷リスクや不正確な測定へのリスクを最小限に抑えます2。ただし、コヒーレンス長が短いため、被測定面を配置する範囲が干渉縞解像のために制限されます。この限られた測定範囲の利点の一つは、制限された測定範囲の外側の光学系のほこりや傷、またその他の欠陥が測定に影響を及ぼすのを防ぐことです (Figure 6)。またこの技術は、設計上で振動の影響を受けにくいため、高価な防振台の上に載せる必要がありません。

Figure 6: 従来の干渉計では光学系にほこりやキズなどの欠陥があると測定時にアーティファクトとして現れるが (左)、低コヒーレンス長干渉計を用いた測定ではこうした欠陥が影響を与えることはない (右)画像提供: InterOptics LLC2
光熱共通光路干渉計
光熱共通光路干渉計 (Photothermal common-path interferometers; PCI) は、集光されたポンプ ビームを用いてターゲットエリアを加熱し、プローブビームが熱膨張による位相歪みを受けた結果、屈折率変化を引き起こします3。PCIは吸収率の正確な測定を行い、光学コーティングの分光特性をより正確に評価することを可能にします。
ポンプビームが活性化している間、プローブビームの位相は加熱領域で歪んでいます。この歪みによって、位相の歪んでいない強いプローブビームの波に対して位相が半周期ずれた2番目の弱い波が発生させます3。この2つの波の干渉はすぐには起きず、試料から少し離れたところで起こります (Figure 7)。加熱によって、プローブビームの反射に同様の位相シフトが前面から加わるため、面吸収の透過率または反射率測定が可能になります。

Figure 7: 光熱共通光路干渉計では熱的歪みがプローブビームからの弱い 第2波を発生させ、その波が歪みのないプローブビームとの干渉パターンをシ ステム後段で発生させる3
連続波 (CW) レーザー光源からの出射ビームをチョップし、試料を周期的に加熱するのに、オプティカルチョッパーが通常用いられます。試料を透過後、プローブビームはその周期的な歪みが測定される前にアパーチャーを通過し ます (Figure 8)。最終的な信号は、試料の吸収率に比例するため、吸収率の正確な測定が可能になります。

Figure 8: 光熱共通光路干渉計の代表的な構成3
こうした吸収率測定は、光学コーティングやバルク基板の分光特性をより良く理解する貴重な情報を与えてくれます。例えば、2つの異なる反射防止コーティングの測定反射率の値が同じであったとしても、吸収や散乱の影響の理解なしではコーティングの真の性能を理解することはできません。2つのコーティングの反射率が同じであっても、その吸収率は異なる場合があるからです。
PCIは、透過率を直接測定して吸収率を求める分光光度計よりも吸収率を正確に測定します3。分光光度計は、微弱な吸収レベルの測定で苦労することがあります。PCIは、コーティングの吸収率の測定をバルク基板の吸収率から分離して行うこともできます。
原子間力顕微鏡法
原子間力顕微鏡法 (Atomic Force Microscopy; AFM) は、表面トポグラフィーを原子分解能で行う測量法です (Figure 9)。極めて小さく先の尖った探針 (チップ) でサンプル面全体をなぞり、面の3D構造を再現します。触針は、顕微鏡ヘッドの他の部分に繋がった矩形または三角形状のカンチレバーに装着されます。カンチレバーの動きは圧電性セラミックによって制御され、これにより、カンチレバーの3Dポジションをナノメートル以下の分解能で確実に行います4。
レーザーオプティクスでは、AFMは光学部品の表面粗さを計算するのに主として用いられます。表面粗さは、レーザー光学系の性能に大きな影響を及ぼすことがあります。なぜなら、それが散乱の主要な要因になることがよくあるからです。AFMは、面の3Dマップを数オングストロームの精度で作り出します5。
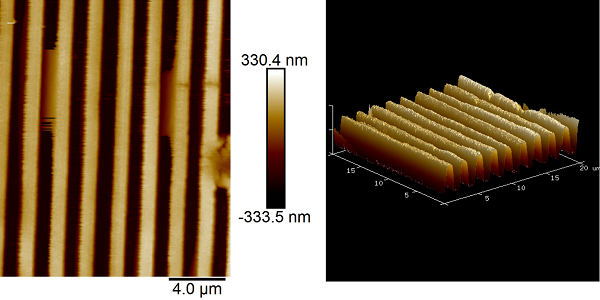
Figure 9: 原子間力顕微鏡はナノメーターレベルのトポグラフィーマップを作り出し、回折格子の形状を確認するのに利用できる
触針は、試料に常時接触しながらその面をスキャンするコンタクトモードか、面と断続的に接触しながらスキャンしていくタッピングモードのどちらかになります。タッピングモードでは、カンチレバーはその共振周波数で振動し、その振動サイクル中の短い時間だけ触針が表面に接触します。コンタクトモードは、タッピングモードほど複雑ではなく、表面をより正確に再現します。しかしながら、スキャンニング中に表面を損傷させる可能性が高くなり、触針がより早く摩耗することから、触針の寿命はより短くなります。両方のモードとも、カンチレバー頭部で反射したレーザーがディテクターに向かいます。試料面の高さの変化でカンチレバーが動き、それによって検出器上のレーザーの位置が変化することで、試料面の正確な高さマップが生成されます (Figure 10)。
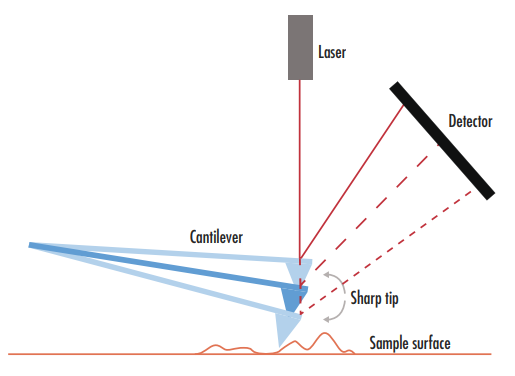
Figure 10: 表面形状の変化がAFMチップを動かし、検出器上の反射レーザーの位置を変化させることで、表面トポグラフィー計測が可能になる
触針の形状と組成は、AFMの空間分解能に重要な役割を担うため、スキャンを要する試料に応じて選択されなければなりません。触針が小さくて尖っているほど、横方向の分解能はより高くなります。しかしながら、触針が小さければスキャンに要する時間が長くなり、大きなものよりも費用がかかります。
触針と試料面間の距離を制御することで、AFMシステムの垂直分解能が決まります。機械的及び電気的なノイズが垂直分解能を制限し、そのノイズレベルよりも小さな試料面の構造は解像することができません6。触針と試料間の相対的な位置も、温度変化に起因するAFM構成部品の膨張や収縮に敏感になります。
AFMは時間のかかる測量法であり、試料面の100μm x 100μm程度の小さな部分の測定が統計学的に製造工程全体を十分に再現できる場合の工程検証やモニタリングに主として用いられます。
白色光干渉計によるスーパーポリッシュ面の表面粗さ測定
白色光干渉計 (White light interferometry; WLI) は、表面粗さの測定にも使用することができます。AFMとWLIの組み合わせは、光学部品メーカーがスーパーポリッシュ面のサブオングストローム RMS 表面粗さの測定も含め、広い空間周波数範囲にわたる表面形状の測定を可能にします。
干渉計の多くは、レーザーのコヒーレンス長の長さが干渉縞の観察を容易にする点から、照明光源に単色レーザーを利用していますが、白色光干渉計は広帯域の照明光源を利用して面の高さを解析します。参照光路長と測定光路長が等しい時に所定の位置での干渉が最も大きくなるため、WLIと被検面間の距離を変化させることで被検面のトポグラフィデータを取得し、同面の高さを計測できます。白色光干渉計は、一方の光路内に被検光学部品を、他方の光路内に参照光学部品を配置するマイケルソン干渉計のレイアウト構成にします (Figure 11)。参照光路の長さは、参照光学部品をある範囲内でスライド移動させることで変化します。
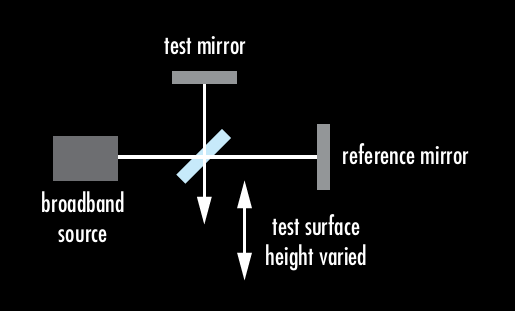
Figure 11: 表面粗さの測定に使用される典型的な白色光マイケルソン干渉計の概略図。被検面の高さを変化させても 装置は静止状態を保つ
WLIとAFMは対応空間周波数範囲が一部重なっており、どちらもスーパーポリッシュ面のサブオングストローム表面粗さ測定に利用することができます (Table 2)。どちらの装置が優れているかは、測定する空間周波数範囲に依存します7 。可視スペクトルでの使用を意図した光学部品の場合、WLIに最適な~2000 サイクル/mmを超えて測定する必要がないことが広く認知されています。しかしながら、UVスペクトルで用いられる光学部品については、WLIの対応空間周波波数範囲よりも高いものが求められる場合があります。AFMは低い空間周波数も測定することができますが (Table 2に見られるように)、他の要因によってAFMの生産性は劣ります。AFMは、測定時間が長く、温度変化や外部振動に対して非常に敏感です。そのため、AFM はテストラボの制御された環境により適し、対するWLI は工場での測定により適しています。
| 装置 | 低空間周波数側限界 (サイクル/mm) | 高空間周波数側限界 (サイクル/mm) | 補足 |
| 白色光干渉計 (Zygo NewView) |
1 3 5 9 25 40 |
50 90 180 360 900 1,800 |
(対物レンズの倍率) 2.75 5 10 20 50 100 |
| 原子間力顕微鏡 | 30 35 45 60 90 185 |
8,000 9,600 12,000 16,000 24,000 50,000 |
チップの曲率と装置構成に依存 |
Table 2: 対物レンズの交換が可能な白色光干渉計と原子間力顕微鏡の対応空間周波数範囲7
シャックハルトマン波面センサー
シャックハルトマン波面センサー (Shack-Hartmann WaveFront Sensor; SHWFS) は、光学部品や光学系の透過波面や反射波面誤差を高いダイナミックレンジと精度で測定します。SHWFSは、その使いやすさや応答性の速さ、相対的に安価、またインコヒーレントな光源を使える点から、広く使われるようになりました。
光の波面は、一定の位相をもつ波の面です。波面は伝搬方向に対して垂直をなす面内にあり、平行な光は平面波であり、収束や発散する光は曲面波を有します (Figure 12)。光学部品に収差があると波面誤差につながり、透過または反射波面に歪みが生じます。透過波面誤差や反射波面誤差を分析することで、光学部品の収差や性能を決定することができます。
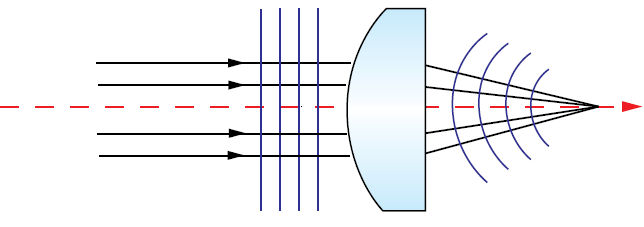
Figure 12: 完全にコリメートされた光は平面波となる。収差の全くない完全なレンズを通過して発散或いは集束する光の波面は球面波になる
SHWFSは、同じ焦点距離をもつマイクロレンズまたは小型レンズのアレイ状素子を利用して入射光の各部分をディテクター上に集光します。ディテクターは小さなセクター毎に分割され、各セクターが各マイクロレンズに対応しています。入射波面が完璧な平面波であると、マイクロレンズアレイの中心点基準間隔と同じ間隔をもつ焦点スポットのグリッドが形成されます。もしいくらかの量の波面誤差をもつ変形波面がSHWFSに入射すると、ディテクター上でのスポットの位置が変化します(Figure 13)。焦点スポットのずれや変形、或いは強度の損失は、各マイクロレンズでの波面の局所的な傾きで決定されます。個々の傾きを用いることで、全体波面を再構築することができます。
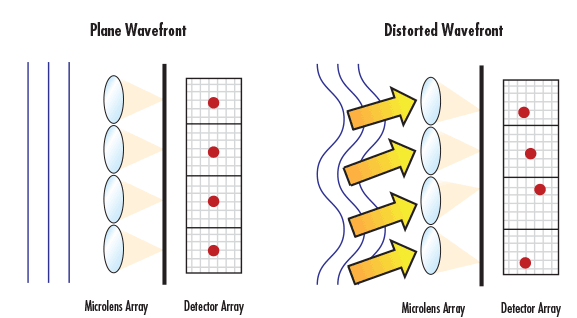
Figure 13: SHWFSに入射する光に波面誤差があると、検出器アレイ上での各焦光スポットのポジションが変位する
光学干渉法と比べた場合のSHWFSの利点の一つに、ダイナミックレンジが実質的に波長と無関係で、より高い柔軟性を持つ点があげられます。とはいえ、SHWFSのダイナミックレンジは、各マイクロレンズに割り当てられたディテクターセクターによって制限されます。波面の正確な再構築を実現するため、各マイクロレンズの焦点スポットは、該当するセクター上で最低10ピクセル分をカバーしなければなりません。焦点スポットによりカバーされるディテクターの面積が大きいと、SHWFSの感度はより高くなる反面、ダイナミックレンジは狭くなってしまうというトレードオフがあります。一般的に、マイクロレンズの焦点スポットは、ディテクターの該当するセクターの半分以上をカバーすべきではなく、これを行うことによって感度とダイナミックレンジ間の合理的な落としどころを保証します8。
アレイ内のマイクロレンズの数が増えると、空間分解能が向上し、マイクロレンズの開口に対する波面スロープの平均化を少なくできますが、各マイクロレンズに割り当てられるピクセル数が少なくなります。マイクロレンズが大きくなると、感度がより高くなり、ゆっくりと変化する波面に対してより正確な測定が行えますが、複雑な波面をサンプリングするのに十分とは言えず、再構築された波面が人工的にスムージングされた結果になります9。
分光光度計
分光光度計は、光学部品の透過率と反射率を測定するもので、光学コーティングの性能を評価するのに不可欠です (Figure 14)。一般的な分光光度計は、広帯域光源、モノクロメーター、検出器から構成されています (Figure 15)。光源からの光は、モノクロメーターの入射側スリットから入射し、回折格子やプリズムなどの分散素子を用いて構成波長に分離します。モノクロメーターの出射側スリットでは、スリットを通過する狭い波長帯域以外のすべての波長は通過を遮断され、その狭い波長帯だけが被検光学部品に照射されます。回折格子やプリズムの角度を変えると、出射側スリットを通過する波長が変化し、テスト波長帯を細かく調整することができます。被検光学部品を反射・透過した光は検出器に直接入射し、所定の波長での同部品の反射率や透 過率が決定されます。

Figure 15: 分光光度計の試験波長は、分光器内の回折格子もしくはプリズムの角度を調整することで細かくチューニングすることができる
誤読を防ぐために、光源は非常に安定し、幅広い波長領域で十分な強度を持つ必要があります。ハロゲンランプは、寿命が長く、明るさを一定に保つことができることから、分光光度計の光源として最もよく使用される一つです10 。非常に広いトータルレンジが必要になる場合は、異なる波長域に対応した複数の光源がよく用いられます。
モノクロメーターのスリット幅が小さいほど、分光光度計のスペクトル分解能は高くなります。しかしながら、スリット幅を小さくしてしまうと、透過光量が減少し、読み取り取得時間やノイズ量が増加する可能性があります12。
分光光度計には、波長域に適した検出器がそれぞれ異なるため、さまざまな検出器が用いられます。紫外、可視、赤外の検出には、光電子増倍管 (Photomultiplier tubes; PMT) や半導体フォトダイオードが一般的に用いられます8。PMTは、他の検出器と比較して比類ない感度を実現する光電面を利用します。光電面に光が入射すると、光電子が放出されて他の二次電子を放出し続けるため、高ゲインを実現できます。PMTの高感度は、低照度光源や高次元の精度が求められる場合に有効です。アバランシェフォトダイオードなどの半導体フォトダイオードはPMTに代わる安価なデバイスですが、PMTよりもノイズが多く、感度は低くなります。
分光光度計の多くは、紫外、可視、あるいは赤外スペクトルでの使用に向けてデザインされていますが、中には10-100nmの波長をもつ極端紫外 (EUV) スペクトルなどの要求のより厳しい波長域で使用されるものがあります。EUV 分光光度計は、格子間隔を極端に小さくした回折格子を通常使用し、入射EUV光を効率よく分散しています。
群遅延分散の測定
表面粗さの測定に加え、白色光干渉計は、反射型・透過型光学部品の群遅延分散 (GDD) の測定にも用いられます。GDDは、超短パルスレーザーの短い持続時間が光媒体で大きな色分散につながることから、超短パルスレーザー用オプティクスの性能に大変重要です。GDDや超短パルスレーザー用オプティクスに関する更なる情報は、超短パルス分散をご覧ください。
干渉計の多くは、レーザーのコヒーレンス長の長さが干渉縞の観察を容易にすることから、単色レーザーを照明光源に利用しますが、白色光干渉計では分散を解析するために広帯域照明を光源に利用しています。白色光干渉計は、一方のアーム内に被検用オプティクス、他方のアーム内に参照用オプティクスを配置するマイケルソン干渉計の構成に通常しています (Figure 16)。参照アームの長さは変化させることができ、配置した参照用オプティクスをある範囲内で直進移動させることができます。
干渉図形は、2本のアームの光路長が同一になるときにその信号が現れますが、その正確な位置は波長に依存します。これにより、波長別の光路長差を正確に決定することができ、被験光学部品のGDDを明らかにしていきます (Figure 16)。

Figure 16: 白色干渉法を用いることで得られる高分散超短パルス用ミラーの対波長GDD特性
信号は、光ディテクターかスペクトロメーター (分光器) で検出されます。光ディテクターは、時間別の異なる波長の信号を統合し、フーリエ変換アルゴリズムを取得干渉図形に適用することで、波長依存のGDDや色分散を明らかにします7。光ディテクターの代わりにスペクトロメーターを用いると、取得データのフーリエ変換の必要性を取り除けます。
光ディテクターベースの白色干渉計の感度は、参照用オプティクスを移動するのに用いるステージのステップサイズに依存しますが、スペクトロメー ターベースのシステムの場合は問題にはなりません。
微分干渉コントラスト顕微鏡法
微分干渉コントラスト (Differential Interference Contrast; DIC) 顕微鏡法 は、透過材料内の欠陥を高感度に検出し、特に光学用コーティングや光学面のレーザー損傷を特定するのに用いられます (Figure 18)。こうした欠陥を従来の明視野顕微鏡法を用いて観察することは、試料が透光性のため困難です。しかしながら、DIC顕微鏡法では、屈折率や表面勾配、或いは厚さの変化に起因する光路長の勾 配を強度の違いに変換して像を結ぶことで、コントラストを改善します。表面勾配やくぼみ、そして面の不連続性のコントラストを強調する画像となり、面のプロファイルを明らかにします。DICの画像は、試料の光路長の変動に対応した3D画像になります。しかしながら、この3D画像は、試料の実際の3Dトポグラフィを表しているわけではありません。

Figure 17: DIC顕微鏡は像面で光路長の勾配を強度の違いに変換し、他の測定法では検出するのが困難なレーザー誘起損傷の可視化を可能にする
DIC顕微鏡法は、光源を振動方向が互いに直交する2つの偏光成分に分離するため、偏光板と複屈折性のウォラストンあるいはノマルスキープリズムを使用します (Figure 18)。2つの振動成分は、顕微鏡の解像限界に等しい距離だけ離れた状態で対物レンズによって試料面上に集光されます。コンデンサーレンズによってコリメートされた後、2つの成分は別のウォラストンプリズムに よって再合成されます。再合成した光は、次に2番目の偏光板、即ち検光子を通過します。検光子の偏光軸は、1番目の偏光板のそれに対して直交するように配置されます。2つの成分の光路長の違いから生じる干渉が、明るさの違いとなって見えるようになります。
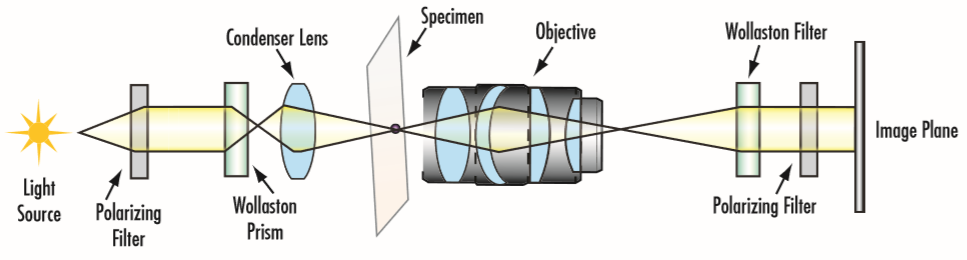
Figure 18: ウォラストンプリズムを用いて入力ビームを2つの偏光成分に分離するDIC顕微鏡法の典型的構成
DIC顕微鏡法の問題の一つに、他の顕微鏡法に比べて高価な点があります。異なる偏光成分の分離や再合成に用いられるウォラストンプリズムは、位相差顕微鏡やホフマン変調コントラスト顕微鏡などの顕微鏡法に必要な部品よりも遥かに高価です11。
動画:エドモンド・オプティクスの測量

今すぐ見る
当社の測量プログラムに関するページ

もっと見る
参考文献
- Hinterdorfer, Peter, and Yves F Dufrêne. “Detection and Localization of Single Molecular Recognition Events Using Atomic Force Microscopy.” Nature Methods, vol. 3, no. 5, 2006, pp. 347–355., doi:10.1038/nmeth871.
- InterOptics LLC. "Engineered coherence interferometry." InterOptics, 2018, http://www.inter-optics.com/tech.html
- Stanford Photo-Thermal Solutions. "Photothermal technology: common-path (single beam) interferometry." Stanford Photo-Thermal Solutions, Nov. 2021, https://www.stan-pts.com/howitworks.html
- InterOptics LLC. "Engineered coherence interferometry." InterOptics, 2018, http://www.inter-optics.com/tech.html
- Stanford Photo-Thermal Solutions. "Photothermal technology: common-path (single beam) interferometry." Stanford Photo-Thermal Solutions, Nov. 2021, https://www.stan-pts.com/howitworks.html
- Binnig, G., et al. “Atomic Resolution with Atomic Force Microscope.” Surface Science, vol. 189-190, 1987, pp. 1–6., doi:10.1016/s0039-6028(87)80407-7.
- Dr. Johannes H. Kindt. “AFM enhancing traditional Electron Microscopy Applications.” Atomic Force Microscopy Webinars, Bruker, Feb. 2013, www.bruker.com/service/education-training/webinars/afm.html.
- Murphey, Douglas B, et al. “DIC Microscope Configuration and Alignment.” Olympus, www.olympus-lifescience.com/en/microscope-resource/primer/techniques/dic/dicconfiguration/
- Paschotta, Rüdiger. Encyclopedia of Laser Physics and Technology, RP Photonics, October 2017, www.rp-photonics.com/encyclopedia.html.
- Forest, Craig R., Claude R. Canizares, Daniel R. Neal, Michael McGuirk, and Mark Lee Schattenburg. "Metrology of thin transparent optics using Shack-Hartmann wavefront sensing." Optical engineering 43, no. 3 (2004): 742-754.
- John E. Greivenkamp, Daniel G. Smith, Robert O. Gappinger, Gregory A. Williby, "Optical testing using Shack-Hartmann wavefront sensors," Proc. SPIE 4416, Optical Engineering for Sensing and Nanotechnology (ICOSN 2001), (8 May 2001); doi: 10.1117/12.427063
- Wassmer, William. “An Introduction to Optical Spectrometry (Spectrophotometry).” Azooptics.com, https://www.azooptics.com/Article.aspx?ArticleID=753.













 前のセクション
前のセクション














もしくは 現地オフィス一覧をご覧ください
クイック見積りツール
商品コードを入力して開始しましょう
Copyright 2023, エドモンド・オプティクス・ジャパン株式会社
[東京オフィス] 〒113-0021 東京都文京区本駒込2-29-24 パシフィックスクエア千石 4F
[秋田工場] 〒012-0801 秋田県湯沢市岩崎字壇ノ上3番地
The FUTURE Depends On Optics®